NANOVIEW: Новый уровень детализации в наномире с атомно-силовым микроскопом
05.06.2025
Мы с радостью сообщаем о новинке онлайн-каталога! NANOVIEW – это сканирующий атомно-силовой микроскоп (АСМ), сочетающий в себе высокую точность, простоту эксплуатации и доступную стоимость. Прибор предназначен для исследований поверхности материалов на наноуровне и идеально подходит для промышленного контроля, анализа покрытий, изучения наноструктур и образовательных задач.

Принцип работы NANOVIEW заключается в сканировании поверхности материала тонким зондом, закрепленным на микроскопической консоли (кантилевере). Процесс начинается с перемещения образца или зонда в горизонтальной плоскости (XY) пьезоэлектрическим сканером, обеспечивающим высокую точность. Система обратной связи непрерывно отслеживает изменения в поведении зонда и управляет пьезоэлектрическим сканером в Z-направлении, поддерживая заданный уровень взаимодействия. На основе этих данных компьютер строит трехмерное изображение поверхности, отображая ее топографию и другие свойства, такие как электрические потенциалы или магнитные поля, обеспечивая исследователям и инженерам детальный анализ материалов и наноструктур.

В отличие от микроскопов других производителей, NANOVIEW разработан с особым вниманием к потребностям промышленного применения. В то время как многие конкурирующие решения ориентированы преимущественно на научные исследования, NANOVIEW особенно востребован в:
|
|
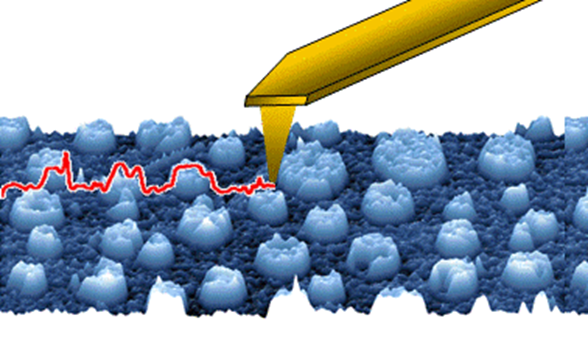
|
При этом прибор сохраняет все ключевые функции исследовательского оборудования, позволяя проводить комплексный анализ поверхности.
NANOVIEW поддерживает основные методики сканирующей зондовой микроскопии:
- STM (Scanning Tunneling Microscopy) – Сканирующая туннельная микроскопия. Использует квантовый туннельный эффект для получения изображений поверхности проводящих или полупроводящих материалов. Между острым зондом и образцом прикладывается небольшое напряжение, и если расстояние между ними достаточно мало (порядка нескольких ангстрем), электроны могут туннелировать через потенциальный барьер.
- MFM (Magnetic Force Microscopy) – Магнитно-силовая микроскопия. Позволяет визуализировать распределение магнитных полей на поверхности магнитных материалов, изучать магнитные домены и другие магнитные структуры.
- KPFM (Kelvin Probe Force Microscopy) – Микроскопия Кельвина. Позволяет изучать распределение электрических потенциалов на поверхности, измерять работу выхода электронов, определять наличие поверхностных зарядов и дефектов.
- AFM (Atomic Force Microscopy) – Атомно-силовая микроскопия. Метод основан на измерении силы взаимодействия между острым зондом, расположенным на конце кантилевера, и поверхностью образца. Зонд сканирует поверхность, и система обратной связи поддерживает постоянное значение силы взаимодействия, регулируя высоту зонда. Доступны два основных режима: контактный (постоянной силы) и колебательный (амплитудно-модулированный).

При выборе оборудования для измерения шероховатости и топографии поверхности часто возникает вопрос: что предпочесть – АСМ или профилометр? Оба метода имеют свои преимущества.
Оптические профилометры
идеальны для:
NANOVIEW незаменим для:
|
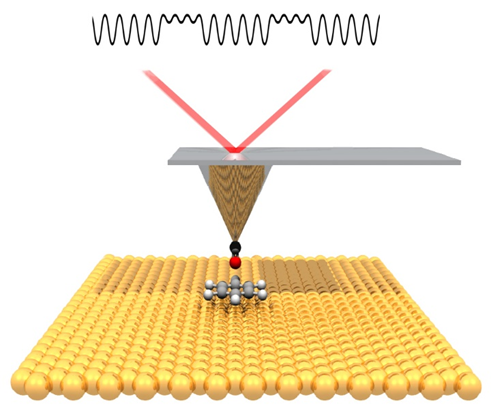
|
Таким образом, для задач, где требуется быстрое измерение шероховатости на относительно больших площадях (от десятков микрометров), действительно лучше подходят профилометры. Однако, когда речь идет о наноразмерных структурах, тонких пленках или комплексном анализе свойств поверхности, NANOVIEW не имеет альтернатив.
Основные характеристики атомно-силового микроскопа NANOVIEW
| Параметр | Значение | Ед. измерения | |
|---|---|---|---|
|
Режим работы
|
контактный, колебательный |
|
|
|
Размер образца
|
≤ 90х20 | мм | |
|
Диапазон сканирования XY
|
до 20 | мкм | |
|
Диапазон сканирования Z
|
до 2 | мкм | |
|
Разрешение сканирования XY
|
0,2 | нм | |
|
Разрешение сканирования Z
|
0,05 | нм | |
| Оптическое увеличение | 4Х |
|
|
| Оптическое разрешение | 2,5 | мкм | |
|
Габариты
|
430х380х710 | мм | |
|
Вес
|
30 | кг | |
Компания «Специальные Системы. Фотоника» является официальным дистрибьютором представленной продукции и оказывает техническую поддержку на территории России и ЕАЭС.
Наши специалисты будут рады проконсультировать вас по интересующим вопросам и подобрать оптимальное решение под ваши задачи. Для оформления заказа или получения консультации, пожалуйста, обратитесь к специалистам нашей компании.
